
Применение технологии рентгеноструктурный анализ в полупроводниковой промышленности
2023-09-20 10:00Мировые расходы на полупроводниковое оборудование вступили в цикл роста. Применение новых технологий и новых продуктов, таких как 5G, Интернет вещей, большие данные, искусственный интеллект и автомобильная электроника, создаст огромный спрос на рынке полупроводников, и отрасль вступит в новый виток роста. Производство пластин, эпитаксиальный выращивание, упаковка и интеграция на переднем конце всей отраслевой цепочки, а также процесс и качество продукции напрямую связаны с последующими отраслевыми приложениями. Ригаку имеет полную систему оборудования, такую какДифракция рентгеновского излучения(РФА), рентгенофлуоресценция (РФА), рентгеновский рефлектометр (XRR) и рентгеновская топография (XRT), которые могут применяться ко всему процессу от производства пластин до интегральных схем и могут выполнять неразрушающее измерение ряда ключевых параметров процесса: таких как толщина , состав, шероховатость, плотность, пористость, а такжеКристальная структураи дефекты кристаллической структуры.
1. При производстве пластин количество и тип дефектов сильно влияют на последующие этапы. Рентгеновская топологическая визуализация (РРТ) позволяет четко наблюдать дефекты и дислокации на поверхности пластины (рис. 1). Помогите производителям улучшить процесс и контролировать качество.
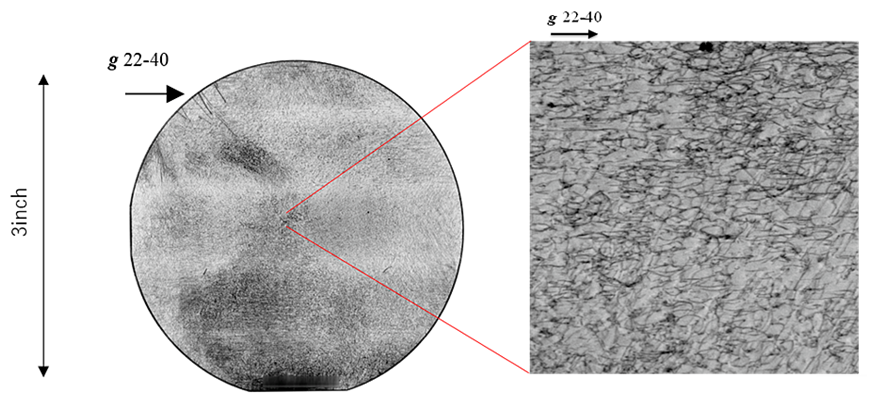
Рисунок 1. Изображение топологии передачи пластины 4H-так в оригинале.
2. Однородность пластины или эпитаксиальной пленки можно измерить с помощьюрентгеноструктурный анализФункция качающейся кривой, а программный модуль визуализации, предоставленный Ригаку, также может создавать двумерные изображения распределения, которые могут интуитивно оценивать качество поверхности (рис. 2).
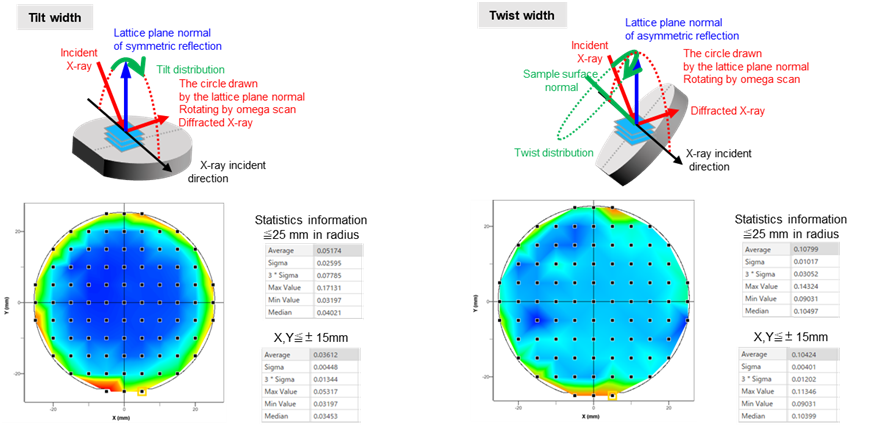
Рисунок 2: Двумерное изображение пленки АлН, растущей на сапфировой подложке.
3. Толщину пленки можно измерить с помощью кривой качания с высоким разрешением, которая является неразрушающей и очень точной (рис. 3).

Рис. 3. Кривая качания высокого разрешения для измерения толщины пленок ГаН/InxGa(1-x)N.
4. Во время роста пластины или эпитаксиальной пленки может возникнуть несоответствие решеток, что повлияет на качество пленки. Используя специальные детекторы и решения Ригаку, в СмартЛаб можно проводить испытания обратного пространства, где решетки не совпадают икристаллографическийконстанты можно увидеть очень интуитивно.
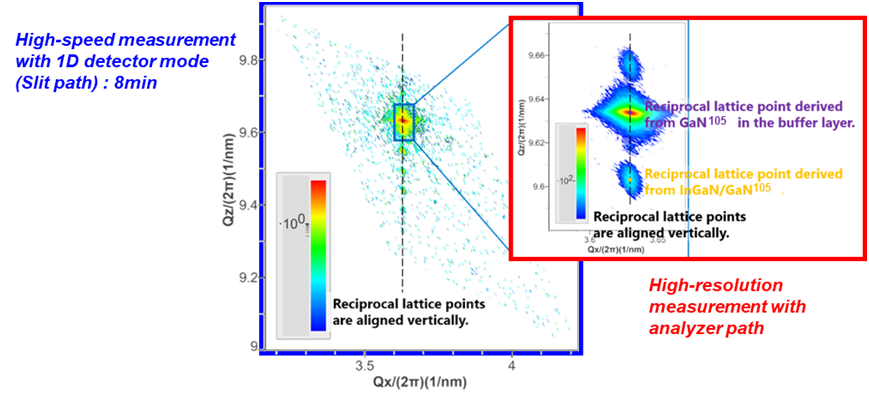
Рисунок 4: Обратный пространственный спектр GaN105 высокого разрешения.
