Рентгенография высокого разрешения (HR-рентгеноструктурный анализ) — это распространенный метод измерения состава и толщины сложных полупроводников, таких как СиГе, AlGaAs, InGaAs и т. д.
При добавлении легирующих примесей или примесей вмонокристаллрешетку методом смещения, решетка будет деформироваться из-за присутствия легирующих атомов. Например, в решетке Си присутствие атомов Ге вызывает деформацию сжатия, поскольку атомы Ге больше атомов Си в решетке. Эта деформация изменяет расстояние между решетками Си, и эту разницу в расстояниях можно обнаружить с помощью HR-рентгеноструктурный анализ.

Рисунок 1: Теоретическое рентгеновское рентгеновское сканирование общей структуры под деформацией сжатия, например, слоя СиГе толщиной 10 нм на подложке Си. Пики при 0 градусах исходят из решетки Си в подложке.
Присутствие более крупных атомов Ге приводит к тому, что атомы Си в слое СиГе располагаются дальше друг от друга, что приводит к смещению дифракционного пика в сторону меньшего угла (слева от пика подложки). Поскольку слой СиГе толщиной 10 нм тоньше, дифракционный пик слоя СиГе намного шире, чем у подложки Си.
В таких пленках для получения дифракционного сигнала можно использовать лишь несколько рядов атомов, расположенных в определенном порядке.Дифракция рентгеновского излученияПик шире, чем дифракция на подложке Си, поскольку в подложке имеются тысячи рядов, которые можно использовать для создания атомной последовательности дифракционных сигналов. Если структура находится под растягивающим напряжением, атомы Си будут расположены ближе друг к другу, чем атомы Си в подложке, и соответствующий дифракционный пик сместится вправо от пика подложки. Дополнительные пики в спектре, называемые"толщина полос,"происходят из-за усиленной интерференции рентгеновских лучей, отраженных от границы раздела между слоем СиГе и подложкой Си. Это тот же сигнал, который используется для анализа рентгеновского отражения (XRR), и его можно использовать для определения толщины деформированного слоя.
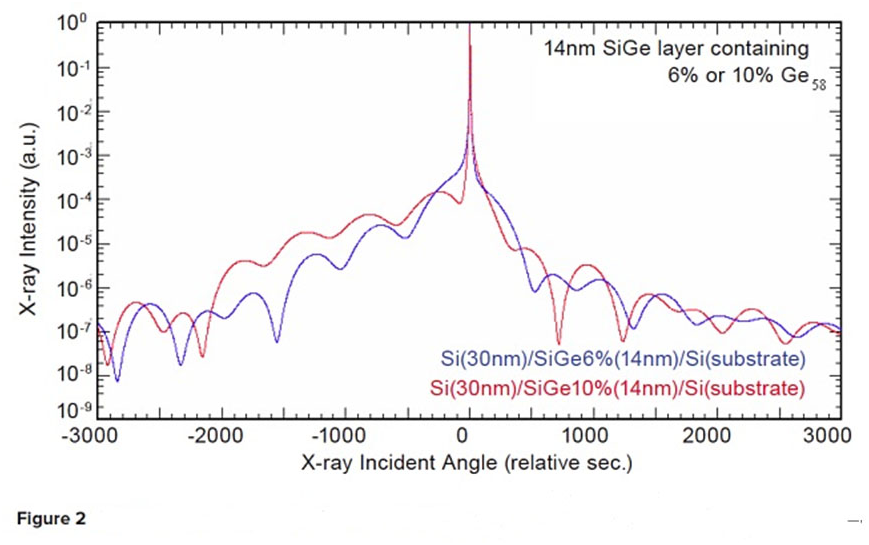
Этот метод можно использовать для определения состава деформированного слоя. На рисунке 2 показано теоретическое рентгеновское рентгеновское сканирование двух образцов, выращенных из 30-нм Си на 14-нм СиГе на кремниевой подложке. В первом случае в решетке содержится 6% Ге, а во втором — 10%. HR-рентгеноструктурный анализ может легко определить разницу между этими двумя структурами и определить толщину слоя на основе полосы толщины.
Кроме того, передовые методы моделирования позволяют точно описывать структурные особенности, например, слои СиГе с градуированной структурой. С помощью HR-рентгеноструктурный анализ можно измерять различные эпитаксиальные материалы, такие как AlGaAs, InGaAs, ИнГаН и т. д. Как правило,рентгеноструктурный анализможно определить состав этих тонкопленочных слоев с точностью менее 1%. Однако следует отметить, что HR-рентгеноструктурный анализ предполагает, что все легирующие атомы присутствуют в решетке.





